
圖 1.平版印刷製程可使用正或負色調抗蝕層來產生圖案1。
第一步,在矽晶圓上旋塗一層感光材料 (光阻) 至所需的薄膜厚度。薄膜透過掩膜和一系列鏡片,以適當波長的紫外線輻射曝光。3-5 Modern chemically amplified photoresists are formulated with a photoacid generator (PAG) which, upon exposure to high energy radiation, decomposes to produce a strong acid.3-5 現代化學放大光阻的配方中加入了光酸產生器 (PAG),當照射到高能量輻射時,PAG 會分解產生一種強酸。這種酸會催化化學反應,例如裂解光阻聚合物上的酸性保護基團,或在光阻聚合物鏈之間形成化學交聯,從而改變光阻劑的溶解特性。3-5 使用顯影溶劑選擇性地移除(顯影)已曝光的材料(正色調抗光劑)或未曝光的材料(負色調抗光劑),導致漫射潛影轉換為整流光阻圖案。最後,光阻圖案可隨後透過反應式離子蝕刻製程轉移至底層基板,例如,反應式離子蝕刻製程。
光刻圖形材料的重要特性
在光學光刻技術中,根據雷利方程式,最終可達到的解析度是入射輻射波長的函數:

其中 R 是解析度(例如、最小臨界尺寸),λ 是入射輻射的波長,NA 是鏡頭系統的數值孔徑,k1 是一個與製程相關的因子,通常介於 0.5 和 0.25 之間。1,2 為了實現更小的特徵尺寸,工業界傳統上已轉向使用更短波長的光,通常需要重新設計光阻,以適應新的輻射波長。1-5 特別是,配方中的非輻射敏感成分必須相對透明,以避免入射輻射的非生產性衰減。舉例來說,基於 4- 羥苯乙烯 (polyhydroxystyrene - PHS) 及其共聚物的光阻聚合物,因其優異的光學、溶解和蝕刻特性,已廣泛應用於 248 奈米輻射;然而,這些芳香族聚合物在 193 奈米波長時會大量吸收。其後,以丙烯酸酯、甲基丙烯酸酯或環烯烴聚合物為基礎的新型光阻相繼被開發出來,這些光阻在 193 奈米波長下是透明的。雖然有關化學增強型光阻材料的全面討論可在其他地方找到,3-5 但在設計新光阻材料時需要考慮的一個重要參數是光阻的溶解行為。前述用於 248 nm 成像的羥苯乙烯基材料傾向於非常均勻地溶解在工業標準的 0.26N 四甲基氫氧化銨 (TMAH) 水溶液顯影液中,而不會在未曝光區域膨脹或過度變薄(暗損失)。相較之下,前述使用羧酸基作為溶解官能性的 193 奈米光阻聚合物平台常顯示出非線性溶解,且在開發初期常有明顯的膨脹現象。這使得以這些材料為基礎的光阻開發相當具有挑戰性,尤其是在負色調配方方面。
HFA 甲基丙烯酸酯聚合物的優異特性
另外,以高氟化醇取代酚基作為溶解官能性的光阻材料也已開發完成。3,6 In particular, the conjugate bases of hexafluoroalcohols (HFAs) (such as 1,1,1,3,3,3-hexafluoro-2-propanol) are inductively stabilized by the heavily electron-withdrawing trifluoromethyl groups such that the alcohols display pKa 值與上述酚類材料 (pKa ~11) 相似。7
HFA 功能化聚合物已被設計用於 248 nm、193 nm 和 157 nm 光刻技術;然而,基於 HFA 功能化甲基丙烯酸酯單體 (Figure 2)的光刻材料,由於其線性溶解行為幾乎沒有膨脹,因此在 193 nm 乾式和浸入式光刻技術中具有優勢。3,6,8-10
。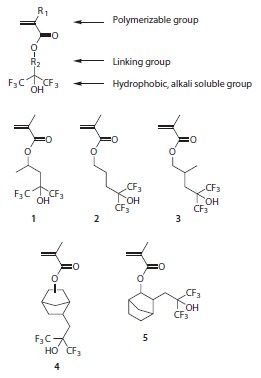
圖 2.設計用於 193 奈米光刻技術的 HFA 功能性甲基丙烯酸酯單體。
這與僅以羧酸為基礎的平版印刷材料的溶解行為形成了對比。例如,在 圖 3 中,甲基丙烯酸共聚物在顯影的初始階段顯示出顯著的膨脹[由石英晶體微天平 (QCM) 測量的厚度增加和電阻偏移所證明],而以 HFA 為基礎的 poly(1) 則顯示出線性溶解。

圖 3.利用 QCM 確定甲基丙烯酸共聚物的溶解行為
Top: poly(methyl methacrylate-co-methacrylic acid) 4:1 (Prod. No. 376914).
Bottom:HFA甲基丙烯酸酯聚合物,使用單體(1)製成。
代表性 HFA 甲基丙烯酸酯均聚物的特性
使用 AIBN 誘導的自由基聚合(Prod.圖 2 表 1中所示的 HFA 甲基丙烯酸酯的均聚物,其特性列於 表 1中。由於低分子量聚合物具有較高的溶解速率,因此使用 1-dodecanethiol (Aldrich Prod. No. )製造低分子量(10 kDa)聚合物。No. 471364)作為鏈轉移劑 (CTA)。在沒有 CTA 的情況下,很容易達到較高的分子量。HFA 甲基丙烯酸酯聚合物的特性可透過修改其分子量、改變連結基團的結構或與其他共聚單體共聚來調整。11,12 尤其是,具有多環基團(例如 4 和 5)的 HFA 甲基丙烯酸酯可用作光阻聚合物中的共聚單體,其中多環基團的作用是增加氧活性離子的耐蝕性。6,8-10 相比之下,具有短支化連接基團的單體 1 已被發現在浸入式光刻應用中特別有用,在這種應用中,高水接觸角和 TMAH 溶解率更為重要。
| 聚合物 2 | Mn [g/mol] | PDI | Ta | 靜態,後退 接觸角leb | ||||
|---|---|---|---|---|---|---|---|---|
| 0.26N | 0.52N | |||||||
| Poly(l) | 4220 | 156 | 89 oC | 125 nm/s | 1010 nm/s | 83o | 87o | 66o |
| 聚(2) | 6130 | 1.14 | 66 oC | 990 nm/s< | 71o | 77o | 50o | |
| Pol)'(3) | 5920 | 1.56 | 55 oC | 245 nm/s< | 75o | 83o | 58o | |
| 聚(4) | 9290 | 1.32 | 159 oC | -0 nm/s | 3.2 nm/s | 77o | 81o | 65o |
| Poly(5) | 11000 | 1.26 | 148 oC | -0 nm/s | -0 nm/s | 86o | 86o | 74o |
aPrepared from Monomers 1-5 in Figure 2, respectively, using AIBN-initiated free radical polymerization.
bMeasured using a tilting table contact angle goniometer.
HFA 甲基丙烯酸酯在光刻/奈米分色材料中的應用
193 奈米光阻劑材料
Figure 4 shows the dissolution behavior (as measured using a quartz crystal microbalance) of a 248 nm photoresist and a 193 nm photoresist as a function of exposure dose using a 254 nm Hg/Xe lamp.與羥苯乙烯基 248 奈米光阻劑相比,以中間劑量製成的部分脫保 193 奈米光阻劑在 TMAH 顯影劑中顯示出明顯的膨脹。在成像效能方面,這種膨脹會導致線緣粗糙度 (LER)、線寬粗糙度 (LWR) 增強,以及製程緯度降低。相比之下,含有單體 4 (圖 4,HFA 光阻)的光阻與基於聚羥苯乙烯的 248 nm 光阻具有相似的溶解行為。
圖 4.上圖:248 奈米光阻,中圖:193 奈米光阻,下圖:193 奈米光阻的溶解行為:基於聚甲基丙烯酸叔丁酯-co-4 的含氫氟烷基 193 奈米光阻。
用於 193 奈米水浸式光刻技術的鹼溶性面漆
半導體產業已轉而採用浸入式光刻技術來取代 157 奈米光刻技術,以擴展 193 奈米光刻技術的功能。15 浸入式光刻技術包括在曝光系統的最終鏡頭元件與光阻之間放置折射率大於空氣的浸入液。15 在 193 nm 時,水是理想的浸入液,因為它透明度高、可在實驗室以低成本獲得高純度的水,而且具有良好的熱、黏度和表面張力特性。由於浸入式光刻只會改變入射輻射的有效波長 (λo/n) 而非真空波長 (λo),因此現有的大量 193 奈米技術 (光源雷射、光學材料、光阻和抗反射材料) 都可以重複使用。
引入浸入式光刻技術需要開發改良的光阻材料,以適應與浸入液的直接接觸。16,17 如 圖 5 所示,浸液會萃取光阻的關鍵成分(如光酸產生器),從而降低成像性能,並可能污染曝光工具,因此會對光阻造成不利影響。16-18 為了克服這些問題,可以使用保護性聚合物面漆來減少光阻成分被萃取到浸入液中,從而保護浸入式掃描器並維持光阻的圖案化性能。16 表層塗層材料的設計目的是展現與水的高後退接觸角,以便快速掃描晶圓而不產生薄膜拉扯(即、19 由於這些殘留水滴會在最終的光刻印刷特徵中產生缺陷,因此浸漬液與表層塗層的後退接觸角會有效地決定最大晶圓掃描率和工具產能。
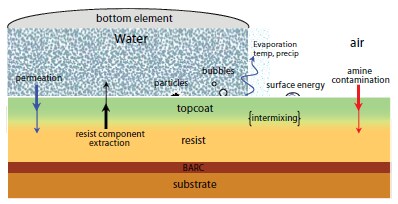
圖 5.浸入式光刻技術中關鍵材料互動的圖形表示。
由於 HFA 甲基丙烯酸酯聚合物獨特地結合了高的、後退的水接觸角和適中的 TMAH 溶解率(與基於其他鹼溶性基團(如羧酸)的聚合物相比),因此在面塗應用中具有特別的優勢。12-14,16,20 此外,HFA 甲基丙烯酸酯聚合物在含酒精的澆鑄溶劑中有很高的溶解度,因此可以在光阻上面澆鑄時,將相互擴散降到最低。
尤其是聚合物 6 (圖 6)在接觸角和溶解速率性能方面表現出理想的平衡,可據此開始設計表面塗層材料。12,16 與氟烷基甲基丙烯酸酯(例如 1,1,1,3,3,3-六氟丙基-2-甲基丙烯酸酯)共聚可以用來增大接觸角,但會犧牲溶解速率(聚合物 圖 6)。nbsp;7, 圖 6)。或者,可以使用含有強酸性基團的共聚單體(例如聚合物 8, 圖 6中的 2-丙烯酰胺基-2-甲基-1-丙磺酸)來調整面漆與光阻劑之間的相互作用,並改善圖案輪廓(例如、14
。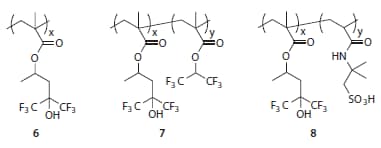
圖 6.用於 193 奈米浸入式光刻技術的表面塗層聚合物範例。
用於 193 奈米水浸式光刻技術的表面活性聚合物添加劑
儘管在水浸式光刻技術中通常會使用保護性表層塗料,但與傳統的乾式光刻技術相比,基於表層塗料的光刻製程需要額外的製程步驟和材料成本。另外,我們也開發了適用於浸水式光刻技術的無表面塗層光阻,在成膜過程中,少量的表面活性含氟聚合物添加劑會析出到光阻表面,以減少光酸產生器的浸出,並控制浸入液與光阻之間的互動。16 這些無表面塗層的光阻旨在實現以表面塗層為基礎的浸入式光刻製程所特有的高產量和低缺陷率,而無需額外的材料和製程成本。16 In general, most additives fall into one of two categories: developer soluble (topcoat type) and switchable (resist type).顯影劑可溶性添加劑需要許多與 HFA 甲基丙烯酸酯類相同的材料特性,這些特性使 HFA 甲基丙烯酸酯類適用於浸入式面漆,包括高水接觸角和在水基顯影劑中的適度溶解速率。可切換添加劑基本上是氟化光阻本身,已針對其表面特性進行最佳化。雖然許多氟化表面活性樹脂可以在圖案製作過程中提供良好的水接觸角,但 HFA 甲基丙烯酸酯材料在鹼性顯影劑存在下會由 pH 誘導從疏水轉變為親水,從而確保在顯影過程中具有良好的顯影劑濕潤性。12,16 例如,使用簡單的含氟聚合物添加劑 9 .配製的未曝光無表層塗料光阻,在顯影過程中呈現高後退接觸角;顯示出與水和水性 TMAH 顯影劑的高後退接觸角,而使用 HFA 基添加劑聚合物 10 配製的類似無表層塗料光阻則顯示出與 TMAH 顯影劑的更小接觸角 (圖 7)。

圖 7.水和 TMAH 顯影劑在使用所示聚合物添加劑配制的無表面塗層光阻上的靜態、後退接觸角。
Network error: Failed to fetch
參考資料
若要繼續閱讀,請登入或建立帳戶。
還沒有帳戶?為便利客戶閱讀,此頁面中文以機器翻譯完成。雖然我們已盡力確保機器翻譯的準確性,但機器翻譯並非完美。如果您對機器翻譯的內容不滿意,請參考英文版本。